삼성전자가 반도체 패키징 기술을 강화하기 위해 ‘연합전선’을 단단하게 구축하고 있다. 세계 파운드리(반도체 위탁 생산) 1위 TSMC의 패키징 기술 경쟁력을 추격하기 위한 포석이다.
5일 업계에 따르면 삼성전자 파운드리는 올해 2.5·3D MDI(Multi Die Integration) 얼라이언스의 파트너사를 30개로 늘렸다. 지난해 20개 파트너사에서 1년 새 10개나 늘었다.
삼성전자는 12·13일(현지 시간) 미국 실리콘밸리에서 개최하는 ‘삼성 파운드리 포럼 2024’에서 MDI 얼라이언스 회원사들을 위한 워크숍도 처음 개최한다. MDI 얼라이언스는 삼성전자가 지난해 6월 출범시킨 반도체 패키징을 위한 연합체다. 반도체 패키징에 필요한 ‘칩렛’과 ‘이종 결합’ 기술을 자유롭게 구현하기 위해 조직했다. 칩렛은 기존 칩에서의 기능을 분리해서 작은 면적의 칩 조각으로 따로 설계하고 제조한 후 후공정 기술로 하나의 칩처럼 합치는 기술이다. 이렇게 만들어진 중앙처리장치(CPU)와 그래픽처리장치(GPU) 등 연산장치, 고대역폭메모리(HBM) 등을 하나로 합치는 기술이 ‘이종 결합’ 패키징이다.
여러 정보기술(IT) 회사가 이 기술에 주목하고 있다. 미세 회로 구현이 한계에 다다르면서 칩 속의 회로를 축소하는 것보다 서로 다른 칩을 쌓아서 결합하는 방법이 비용이나 생산 시간 면에서 더 효율적이라는 판단에서다. 엔비디아·AMD 등 세계 최대 회사들의 도전을 시작으로 점차 이 기술이 범용화할 것이라는 전망이 나온다.
삼성전자는 파운드리·HBM·패키징을 ‘원스톱’으로 구현할 수 있다는 장점이 있지만 칩 결합에서 발생하는 다양한 소프트웨어 문제를 해결하려면 협력이 효율적이다. 업계 관계자는 “CPU와 GPU·메모리는 서로 다른 설계 방식으로 만들어져 있기 때문에 이들을 통합하는 과정이 상당히 어렵다”며 “삼성전자는 이 과정을 더욱 수월하게 하기 위해 설계·후공정 업체, 설계자동화(EDA) 툴 회사들과 연합군을 구성하는 방법을 택했다”고 설명했다.
TSMC 역시 ‘3D 패브릭 얼라이언스’라는 연합체를 통해 20여 개의 파트너사와 고급 패키징 기술을 고도화하고 있다. TSMC는 ‘칩온웨이퍼온서브스트레이트(CoWoS)’라는 칩 결합 브랜드로 선단 패키징 업계를 휘어잡았다. 엔비디아와 인텔·AMD 등 세계적인 팹리스 기업들은 물론 구글·메타 등 세계 최대 IT 빅테크가 TSMC 패키징 라인을 활용하기 위해 문을 두드리고 있다.
업계의 또 다른 관계자는 “삼성전자가 아이-큐브(i-Cube) 등 이종 결합 패키징 기술로 TSMC의 아성을 깨려는 노력을 하고 있지만 워낙 TSMC의 신뢰도와 기술력이 강하다”며 “삼성 파운드리가 MDI 얼라이언스 등 열린 생태계를 지향해야만 이들의 기술력을 따라잡을 수 있다”고 설명했다.
< 저작권자 ⓒ 서울경제, 무단 전재 및 재배포 금지 >









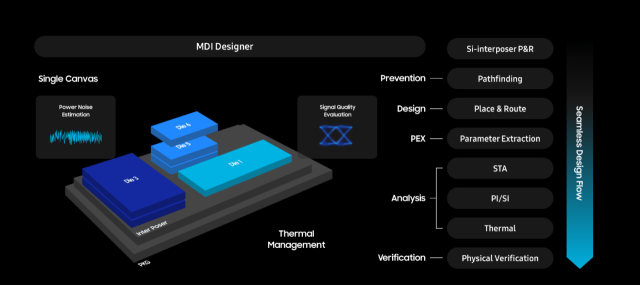

 hr@sedaily.com
hr@sedaily.com







































